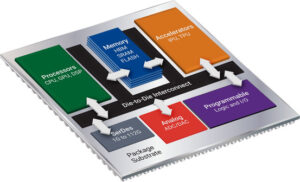 Synopsys and TSMC have collaborated to deliver certified design flows for advanced packaging solutions using the Synopsys 3DIC Compiler product for both silicon interposer based Chip-on-Wafer-on-Substrate (CoWoS-S) and high-density wafer-level RDL-based Integrated Fan-Out (InFO-R) designs. 3DIC Compiler provides packaging design solutions required by today’s complex multi-die systems for applications like high-performance computing (HPC), automotive and mobile.
Synopsys and TSMC have collaborated to deliver certified design flows for advanced packaging solutions using the Synopsys 3DIC Compiler product for both silicon interposer based Chip-on-Wafer-on-Substrate (CoWoS-S) and high-density wafer-level RDL-based Integrated Fan-Out (InFO-R) designs. 3DIC Compiler provides packaging design solutions required by today’s complex multi-die systems for applications like high-performance computing (HPC), automotive and mobile.
The Synopsys 3DIC Compiler solution provides a unified chip-package co-design and analysis environment for creating an optimal 2.5D/3D multi-die system in a package. The solution includes features such as TSMC design macro support and auto-routing of high-density interposer based interconnects using CoWoS technology. For RDL-based InFO designs, schedules are reduced from months to a few weeks through automated DRC-aware, all-angle multilayer signal and power/ground routing, power/ground plane creation, and dummy metal insertion, along with the support for TSMC design macros.
For CoWoS-S and InFO-R designs, dies need to be analyzed in the context of the package and the overall system. Die-aware package and package-aware die power integrity, signal integrity, and thermal analysis are critical for design validation and signoff. Integration of Ansys’ RedHawk family of chip-package co-analysis solutions in 3DIC Compiler meets this critical need, enabling seamless analysis and faster convergence to an optimal solution. Customers can achieve smaller designs and higher performance by eliminating overdesign.

